Биполярные транзисторы на гетеропереходах
Некоторые исследовательские проекты нацелены на создание гетеропереходных биполярных транзисторов на основе кремниевой технологии, что позволит использовать в них кремниевые полупроводниковые соединений с широкой запрещенной зоной. Одним из таких соединения является карбид кремния SiC (для которого ширина запрещенной зоны изменяется от 2,3 эВ для кубической модификации до более чем 3 эВ для гексагональных модификаций), а другим, весьма интересным для проектировщиков веществом выступает аморфный гидрогенизированный кремний (ширина зоны - 1,6 эВ). Техническая проблема при использовании этих материалов связана с высоким сопротивлением эмиттера, обусловленным либо свойствами самих материалов, либо металлическими контактами. По-видимому, наиболее перспективными кремниевыми материалами для получения НВТ являются сплавы на основе SiGe, в которых гетеропереходы могут быть сформированы вследствие того, что ширина запрещенной зоной в кремнии равна 1,12 эВ, а в германии - 0,66 эВ. Приборы с гетероструктурами Si -SiGe были созданы лишь в 1998 г. (т. е. значительно позднее приборов на GaAs и других соединениях класса AIIIBV), что легко объясняется недостаточным развитием методов эпитаксиального роста SiGe. Для изготовления НВТ на основе Si или SiGe необходимо, чтобы в создаваемой структуре сразу после кремниевой области эмиттера располагалась область базы SiGe, в которой ширина запрещенной зоны намного меньше, чем в Si, поскольку именно такая разница в ширине запрещенной зоны позволяет создавать в области базы относительно высокую концентрацию легирующих примесей, что и обеспечивает высокую рабочую частоту структуры, сравнимую с частотой приборов на основе соединений AIIIBV.
Частота отсечки промышленно выпускаемых гетеропереходных биполярных транзисторов в настоящее время превышает 100 ГГц, а в опытных образцах - даже 400 ГГц. Такие высокие значения частоты отсечки частично связаны с использованием структур со сжимающими механическими напряжениями, что позволяет менять энергетическую структуру в напряженных слоях, в результате чего происходит уменьшение эффективной массы носителей. Повышение подвижности носителей при этом может достигать 60%.
Конечным результатом описанных приемов стало создание базовых областей с плавным изменением состава х в соединениях типа GexSi1-x. Наклон энергетической зоны, возникающий вследствие изменений ширины запрещенной зоны вдоль базовой области, обеспечивает очень высокие значения (вплоть до ~10 кВ/см) встроенного электрического поля, что и позволяет резко уменьшить время прохождения электронами базовой зоны. Такие гетеропереходные биполярные транзисторы (НВТ), конечно, потребляют и рассеивают гораздо больше энергии, чем полевые МОП-транзисторы, однако позволяют работать при гораздо более высоких частотах и при меньшем уровне шумов. Эти преимущества и позволяют рассматривать гетеропереходные биполярные транзисторы на основе SiGe в качестве весьма перспективных приборов.
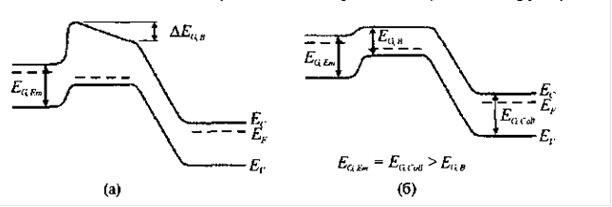
Рис. 4 (а) Гетеропереходный биполярный транзистор (HBT) с базой переменной ширины запрещенной зоны; (б) двойной гетеропереходный биполярный транзистор (DHBT) с широкой запрещенной зоной полупроводника в области эмиттера и коллектора
Статья в тему
Механический и лазерный гироскоп
Цель
контрольной работы - произвести сравнительный анализ конструктивных решений,
характерных при построении электронно-оптических и электромеханических
гироскопов.
Решаемые
задачи:
Характеристика
электромеханических гироскопов.
Характеристика
электронно-оптических гироско ...